晶圆级CSP装配的底部填充工艺
[09-12 18:49:21] 来源:http://www.88dzw.com PCB设计 阅读:8890次
文章摘要:人们对一些应用在手持设各如手机和数码相机等上的CSP的机械连接强度和热循环可靠性非常关注。由于 组件中的各种材料的热膨胀系数不匹配,轻微的热变形就会导致应力存在于细小的焊点中。为了改善这种现 象,提高组件的机械连接强度和热循环可靠性,需要对CSP的装配进行底部填充。但是底部填充需要增加设 备和工艺,同时也会使重工复杂化,需要综合考虑。完整的底部填充如图1所示。图1 完整的底部填充本文介绍的是底部填充方法——局部填充,可以应用在CSP或BGA的装配中。局部填充是将底部填充材料以 点胶或印刷的方式沉积在基板上位于元件的4个角落处或四周(如图2和图3所示)。相比毛细流动或非流动 性底部填充材料,应用
晶圆级CSP装配的底部填充工艺,标签:pcb培训,pcb是什么,pcb软件,http://www.88dzw.com人们对一些应用在手持设各如手机和数码相机等上的CSP的机械连接强度和热循环可靠性非常关注。由于 组件中的各种材料的热膨胀系数不匹配,轻微的热变形就会导致应力存在于细小的焊点中。为了改善这种现 象,提高组件的机械连接强度和热循环可靠性,需要对CSP的装配进行底部填充。但是底部填充需要增加设 备和工艺,同时也会使重工复杂化,需要综合考虑。完整的底部填充如图1所示。

图1 完整的底部填充
本文介绍的是底部填充方法——局部填充,可以应用在CSP或BGA的装配中。局部填充是将底部填充材料以 点胶或印刷的方式沉积在基板上位于元件的4个角落处或四周(如图2和图3所示)。相比毛细流动或非流动 性底部填充材料,应用于此工艺的材料黏度较高。如Loctite FP640l,其黏度在室温时达300 000~ 600000Cps。局部填充工艺的特点是:
·底部填充材料被沉积在基板上元件角落处或四周;
·填充材料不会流动,焊点周围不能有填充材料:
·由于焊点周围没有填充材料,重工会更容易;
·可以选择UV材料,使用紫外线使填料固化,而不应用加热固化方式。


图2 4个角落处做局部底部填充 图3 4个角落处儆局部底部填充贴装示意图
(1)胶量的控制和元件周围空间的考虑
在点胶或印胶之前需要精确估计胶量,过多的胶量会污染周围其他的元件和焊盘,同时,过多的胶会流入 元件底部污染焊点;胶量太少则元件侧面或角落处的胶爬升不够。
针对不同的元件具体需要多少的胶量,没有精确计算的公式,需要通过试验来确定。在确定胶量的同时, 需要考虑周围是否有足够的空间来施加胶水。一般比较便捷的评估方法是首先准备一块大小和将要装配的元 件相同的玻璃片,玻璃片的一面具有和元件焊球高度一样的立高结构,然后将评估的胶量印刷或点在基板适 当的位置,最后将准备好的玻璃片贴在基板上,在显微镜下观察是否有胶污染元件底下的焊盘或周围其他焊 盘,并注意填充胶不要污染元件旁边的局部基准点。图4和图5是在基板上元件所在位置4个角落处点胶,材 料为Loctite 35 15,每个点为0.75 mg,贴上玻璃片模拟元件的贴装,发现左上角胶点太靠近焊盘,可能会 污染到焊点。所以需要减少胶量或将点胶的位置稍向外挪。当将胶点的质量降到0.5 mg时,发现每个胶点会 不均匀。

图4 4个角落处点胶,材料Loctite 3515每个胶点0.15 mg
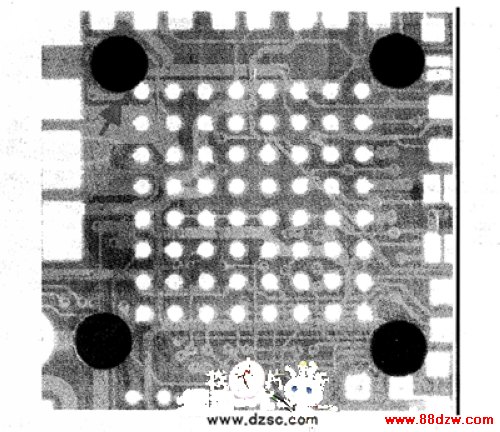
- 上一篇:晶圆级CSP装配回流焊接工艺控制
《晶圆级CSP装配的底部填充工艺》相关文章
- › 晶圆级CSP的返修完成之后的检查
- › 晶圆级CSP的元件的重新贴装及底部填充
- › 晶圆级CSP的焊盘的重新整理
- › 晶圆级CSP的返修工艺
- › 晶圆级CSP装配的底部填充工艺
- › 晶圆级CSP装配回流焊接工艺控制
- 在百度中搜索相关文章:晶圆级CSP装配的底部填充工艺
- 在谷歌中搜索相关文章:晶圆级CSP装配的底部填充工艺
- 在soso中搜索相关文章:晶圆级CSP装配的底部填充工艺
- 在搜狗中搜索相关文章:晶圆级CSP装配的底部填充工艺




 当前位置:
当前位置: