晶圆级CSP装配的底部填充工艺
[09-12 18:49:21] 来源:http://www.88dzw.com PCB设计 阅读:8890次
文章摘要:图9 实验采用WLCSP 图10 实验采用PCB其中,两组样品在元件四周或4个角落进行局部填充,然后在温度238°C下回流焊接和胶水固化,回流温度 曲线如图11、图12和图13所示。图11 回流焊接温度曲线 图12 元件四周点胶 图13 元件四角点胶 测试结果发现,两种点胶方式,在可靠性方面没有明显差异(置信
晶圆级CSP装配的底部填充工艺,标签:pcb培训,pcb是什么,pcb软件,http://www.88dzw.com图9 实验采用WLCSP 图10 实验采用PCB
其中,两组样品在元件四周或4个角落进行局部填充,然后在温度238°C下回流焊接和胶水固化,回流温度 曲线如图11、图12和图13所示。
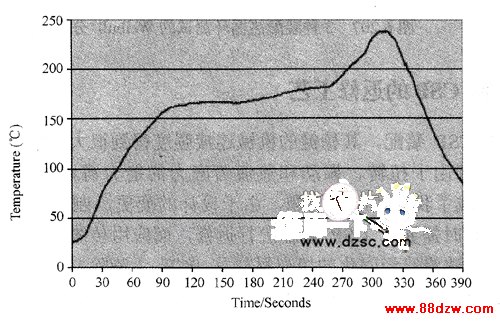
图11 回流焊接温度曲线
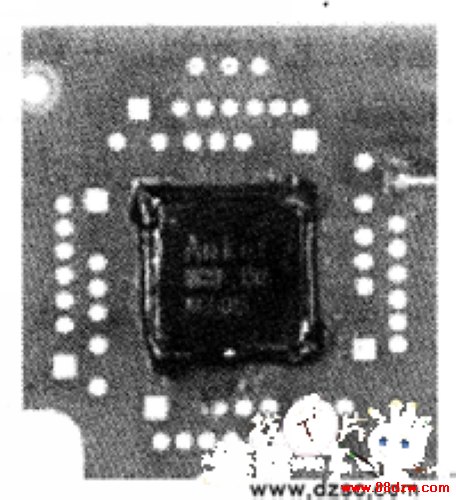
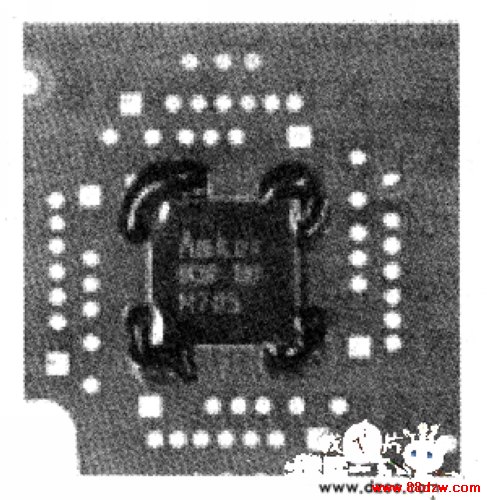
图12 元件四周点胶 图13 元件四角点胶
测试结果发现,两种点胶方式,在可靠性方面没有明显差异(置信度P=0.583),但是相比采用锡膏装配 不进行局部填充的样品,其可靠性提升了将近3倍,其热循环性能强烈依赖于胶水的特性,采用其他玻璃化 转变温度更高,热膨胀系数较低,填充物含量较高的胶水,采用局部填充的装配方式,其可靠性至少可以提 升5倍。但是周边底部填充和四角底部填充的方法虽然可有效提升晶圆级CSP装配件的可靠性,但需要额外的 工艺控制。
3种装配热循环测试的Weibull分析如图14所示。

图14 3种装配热循环测试的Weibull分析
欢迎转载,信息来源www.88dzw.com(www.88dzw.com)
Tag:PCB设计,pcb培训,pcb是什么,pcb软件,PCB设计
- 上一篇:晶圆级CSP装配回流焊接工艺控制
《晶圆级CSP装配的底部填充工艺》相关文章
- › 晶圆级CSP的返修完成之后的检查
- › 晶圆级CSP的元件的重新贴装及底部填充
- › 晶圆级CSP的焊盘的重新整理
- › 晶圆级CSP的返修工艺
- › 晶圆级CSP装配的底部填充工艺
- › 晶圆级CSP装配回流焊接工艺控制
- 在百度中搜索相关文章:晶圆级CSP装配的底部填充工艺
- 在谷歌中搜索相关文章:晶圆级CSP装配的底部填充工艺
- 在soso中搜索相关文章:晶圆级CSP装配的底部填充工艺
- 在搜狗中搜索相关文章:晶圆级CSP装配的底部填充工艺
分类导航
最新更新




 当前位置:
当前位置: