倒装晶片的组装的助焊剂工艺
[09-12 18:47:46] 来源:http://www.88dzw.com PCB设计 阅读:8162次
文章摘要:助焊剂工艺在倒装晶片装配工艺中非常重要。助焊剂不仅要在焊接过程中提供其化学性能以驱除氧化物和油污 ,润湿焊接面,提高可焊性,同时需要起到黏接剂的作用。在元件贴装过程中和回流焊接之前黏住元件,使其固 定在基板的贴装位置上。此类阻焊剂相比于其他普通的助焊剂有更高的黏度,它需要提供足够的黏力来保证晶片 在传输过程中及回流焊接炉中不发生移动。我们之所以选择助焊剂而非锡膏,是因为超细间距的锡膏印刷会有很大的“桥连”风险;同时考虑到混合装配 工艺的兼容性,免洗型助焊剂是一个比较好的替代方案。如何选择合适的助焊剂及其量的控制是该工艺的关键。不同的助焊剂的润湿能力,黏度及与其他材料的兼容性 会不一样。助焊剂量
倒装晶片的组装的助焊剂工艺,标签:pcb培训,pcb是什么,pcb软件,http://www.88dzw.com助焊剂工艺在倒装晶片装配工艺中非常重要。助焊剂不仅要在焊接过程中提供其化学性能以驱除氧化物和油污 ,润湿焊接面,提高可焊性,同时需要起到黏接剂的作用。在元件贴装过程中和回流焊接之前黏住元件,使其固 定在基板的贴装位置上。此类阻焊剂相比于其他普通的助焊剂有更高的黏度,它需要提供足够的黏力来保证晶片 在传输过程中及回流焊接炉中不发生移动。
我们之所以选择助焊剂而非锡膏,是因为超细间距的锡膏印刷会有很大的“桥连”风险;同时考虑到混合装配 工艺的兼容性,免洗型助焊剂是一个比较好的替代方案。
如何选择合适的助焊剂及其量的控制是该工艺的关键。不同的助焊剂的润湿能力,黏度及与其他材料的兼容性 会不一样。助焊剂量的多少会影响到焊接完成后其在基板上的残留量,而助焊剂的残留量会影响后面的底部填充 工艺及产品的长期可靠性。由于晶片与基板之间的间隙非常小,要清除晶片底下残留的助焊剂非常困难,所以, 需要选择低残留免清洗的助焊剂。
(l)助焊剂的黏性和应用方式
助焊剂是非牛顿流体,它的黏度会随环境温度、剪切应力及剪切速度而变化。黏度的国际单位为帕斯卡・秒( Pa・s),常见的单位有泊(P)、厘泊(cP)、斯托克斯(St)、厘斯托克斯(cSt)等,它们的换算关系如表1 所示。助焊剂的应用方式一般有喷涂、针传输、利用各种阀点涂、浸蘸和刷涂、应用方式和黏度相关,一般适合 浸蘸的助焊剂的黏度在4 000~10 000 cP,I/0数多及大的晶片要求助焊剂的黏度要低些,或者这时需要特殊的 吸嘴夹持。而采用点涂或喷涂方式的助焊剂黏度较之要低,因其含固体成分的百分比要低,所以回流焊接后焊点 周围的助焊剂残留量要少。一些助焊剂的特性及应用方式如表2所示。
表1 黏度单位换算关系
表2 一些助焊剂特性及应用方式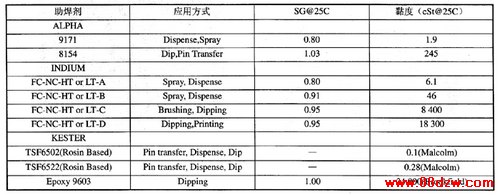
(2)助焊剂的润湿能力
助焊剂必须有足够的润湿能力保证可焊性。不同的助焊剂润湿能力不太一样,受影响于其活性、回流焊接的环 境、焊接材料、焊盘的表面处理方式、焊接表面的氧化程度和焊接面的大小。有的助焊剂只能适合在惰性环境里 焊接,雨有些助焊剂既可以应用在空气环境中,又可以应用在惰性焊接环境中。
我们可以通过实验来评估助焊剂的润湿能力。将蘸有助焊剂的元件贴在氧化程度不一样的铜板上,回流焊接后 ,量测焊料在铜板上铺开的面积就可以评估不同助焊剂的润湿能力了。在铜板上焊料铺开面积越大,说明可焊性 越好。
不同的助焊剂,不同厚度和不同的焊盘氧化程度,润湿能力的测试如图1所示。需要注意的是:如上所述,可 焊性会受回流焊接环境和焊盘表面处理等因素的影响,此测试方法可以为我们提供一种参考。
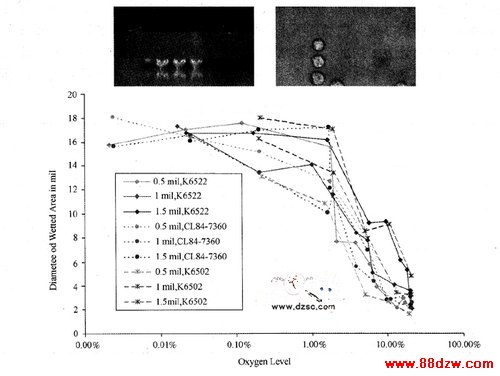
图1 不同厚度的几种助焊剂对不同氧化程度焊盘润湿能力
在实际生产条件下,SnPb焊球蘸取Multicore MP200,KesterTAC23几种助焊剂,在空气回流焊接环境中获得了 比较好的焊接效果,如图2所示.
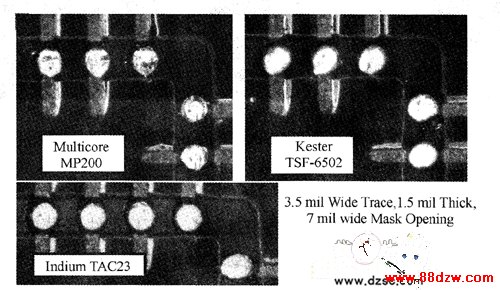
图2 焊接效果图
我们来比较在氮气回流环境和空气中回流焊接的效果。同样采用SnPb元件,焊接在OSP表面处理的焊盘上,结果 是惰性回流环境中焊接效果要好,锡铅的焊接性能比无铅焊好,尤其是在无铅焊接工艺中,必须要使用氮气焊接 环境,并且控制氧气浓度在50 PPM。如图3所示。
- 上一篇:贴片机按功能分类
《倒装晶片的组装的助焊剂工艺》相关文章
- › 倒装晶片的回流焊接及填料固化后的检查
- › 倒装晶片的非流动性底部填充工艺
- › 倒装晶片的底部填充工艺
- › 倒装晶片的组装焊接完成之后的检查
- › 倒装晶片的组装的回流焊接工艺
- › 倒装晶片的贴装工艺控制
- 在百度中搜索相关文章:倒装晶片的组装的助焊剂工艺
- 在谷歌中搜索相关文章:倒装晶片的组装的助焊剂工艺
- 在soso中搜索相关文章:倒装晶片的组装的助焊剂工艺
- 在搜狗中搜索相关文章:倒装晶片的组装的助焊剂工艺




 当前位置:
当前位置: