倒装晶片的底部填充工艺
[09-12 18:50:07] 来源:http://www.88dzw.com PCB设计 阅读:8681次
文章摘要:边缘圆角对于组件可靠性非常关键,它与环境、填料本身的特性、助焊剂及阻焊膜和基板的厚度相关。边缘圆角厚度是指元件下表面一边与填料由于爬升至元件侧面形成弧线的切线之间的距离,如图3和图4所示。那么圆角厚度多少才合适呢?3~10 mil对一些在热循环中有较好表现的材料比较适合。太薄则容易与晶片和基 板分离,过厚则在角落出容易出现裂纹,或在附近焊点出现分层。由于胶水分配工艺稳定性的原因,胶水量在10 %内变动属于正常。如图5所示。 图3 底部填充边缘圆角俯视图
倒装晶片的底部填充工艺,标签:pcb培训,pcb是什么,pcb软件,http://www.88dzw.com边缘圆角对于组件可靠性非常关键,它与环境、填料本身的特性、助焊剂及阻焊膜和基板的厚度相关。
边缘圆角厚度是指元件下表面一边与填料由于爬升至元件侧面形成弧线的切线之间的距离,如图3和图4所示。
那么圆角厚度多少才合适呢?3~10 mil对一些在热循环中有较好表现的材料比较适合。太薄则容易与晶片和基 板分离,过厚则在角落出容易出现裂纹,或在附近焊点出现分层。由于胶水分配工艺稳定性的原因,胶水量在10 %内变动属于正常。如图5所示。
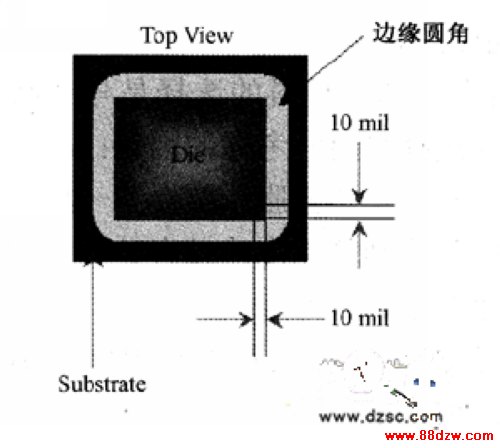

图3 底部填充边缘圆角俯视图 图4 底部填充边缘圆角剖视图
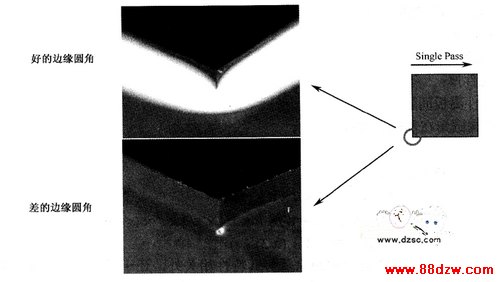
图5 底部填充边缘圆角外观图
(2)底部填充工艺控制
基板在底部填充之前需要烘烤,倒装晶片基材是硅,无须烘烤。烘烤目的是为了驱除基板/组件内的水汽,防 止在固化过程中受热蒸发进入填料而形成气泡。基板/组件需储存在干燥环境中,仅在底部填充前烘烤。烘烤时 间依赖于组件/基板的构造,阻焊膜内的水汽一般125℃下30 min便可驱除,但内层水汽即使125℃烘烤2h还不能 驱除。焊盘表面处理方式是OSP的基板需要考虑在烘烤过程中氧化的问题。
一般填充材料在一定温度下毛细流动速度较低温下快,所以底部填充材料都需要预热到一定温度,以便其在元 件底部的流动。板上预热温度可以控制在90℃左右,或依照材料的使用说明设置适当的预热温度。胶水一般保存 在-40~-60℃的低温环境中,使用前需要将其从超低温冰箱中取出回温到室内温度。胶量的控制对于合适的边 缘圆角形成非常关键。我们可以设定如图6所示的模型,进行理论胶量的计算,但是更重要的是控制稳定的胶水 流量,形成满意的边缘圆角。

图6 理论胶量计算模型
模型建立:总的胶量可以分割成元件底部和四周圆角两
・Vt:理论胶量:
・vs:元件底部胶量:
・Vf:元件四周圆角胶量:
・I:元件宽:
・W:元件长:
・h:元件厚;
・s:元件离板间隙:
・r:边缘圆角在基板上的宽。
・n:焊球的数量
则

- 上一篇:拱架式贴片机结构
《倒装晶片的底部填充工艺》相关文章
- › 倒装晶片的回流焊接及填料固化后的检查
- › 倒装晶片的非流动性底部填充工艺
- › 倒装晶片的底部填充工艺
- › 倒装晶片的组装焊接完成之后的检查
- › 倒装晶片的组装的回流焊接工艺
- › 倒装晶片的贴装工艺控制
- 在百度中搜索相关文章:倒装晶片的底部填充工艺
- 在谷歌中搜索相关文章:倒装晶片的底部填充工艺
- 在soso中搜索相关文章:倒装晶片的底部填充工艺
- 在搜狗中搜索相关文章:倒装晶片的底部填充工艺




 当前位置:
当前位置: